機器一覧
リソグラフィー
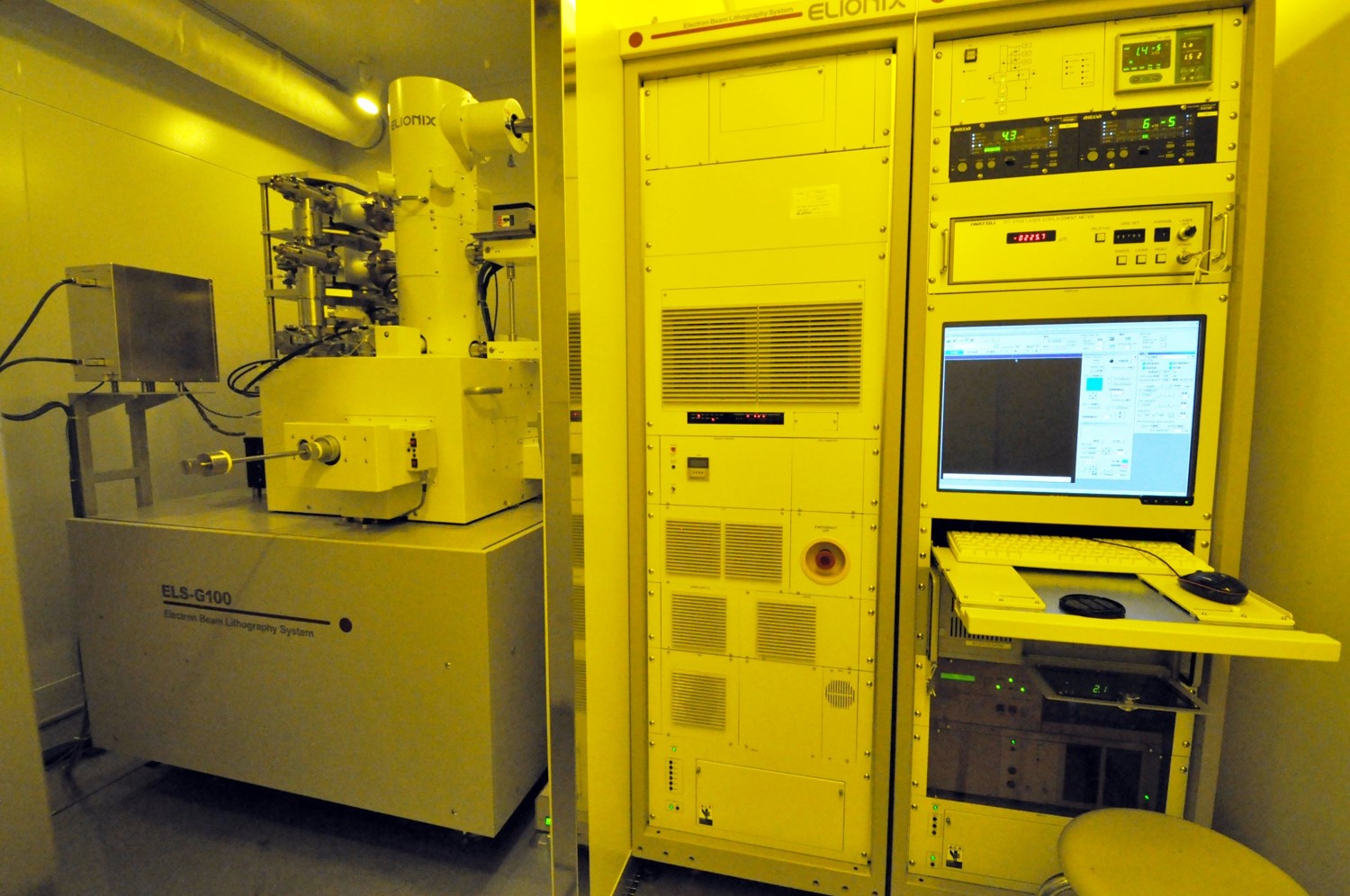
RO-111
超高精度電子ビーム描画装置
CR
エリオニクス(ELS-G100)
機能及び仕様
ポイントビーム方式,加速電圧25,50,75,100kV,最小線幅6nm,
対応ウェハ
2-6 インチ、カットウェハ
機器利用料(円/時間)
12,650
設置場所
CR東棟1F

RO-112
マスクレス露光装置
CR
ナノシステムソリューションズ(DL-1000)
機能及び仕様
デジタルマイクロミラーデバイス(DMD)方式によるマスクレス露光, 最小線幅1μm,レーザ光源405nm 0.5W
対応ウェハ
2-4 インチ、カットウェハ他
機器利用料(円/時間)
6,600
設置場所
CR東棟1F
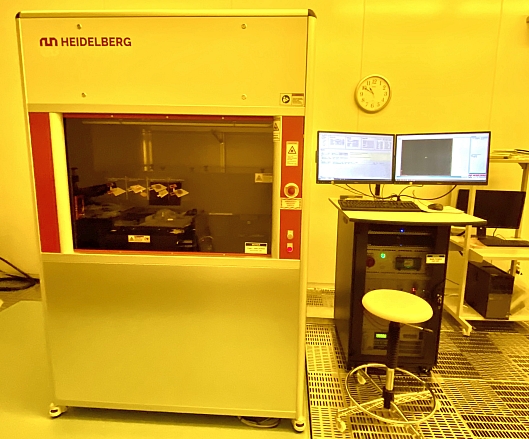
RO-113
マスクレス露光装置
CR
ハイデルベルグ・インストルメンツ(MLA150)
機能及び仕様
デジタルマイクロミラーデバイス(DMD)方式によるマスクレス露光, 最小線幅1μm,レーザ光源375nm 7.2W、バックアライメント対応
対応ウェハ
2-6 インチ、カットウェハ
機器利用料(円/時間)
8,800
設置場所
CR東棟1F

RO-121
スピンコーター
CR
タツモ(TMR6100)
機能及び仕様
レジスト等のスピンコーティング
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
2,200
設置場所
CR西棟1F

RO-122
プログラム・ホットプレート
CR
アズワン(EC-1200NP)
機能及び仕様
16ステップ以内のプログラムを4パターン記憶 制御可能温度範囲:室温 +50 ~ 300℃
対応ウェハ
プレート面積: 412*312mm
機器利用料(円/時間)
2,200
設置場所
CR

RO-123
インビトロシェーカー
CR
タイテック(Wave-PR2)
機能及び仕様
振とう方式::波動形揺動(マイルド振とう)、振とう速度/角度:5 ~ 50r/min、2 ~ 6°
対応ウェハ
架台有効寸法: 300×200mm
機器利用料(円/時間)
2,200
設置場所
CR

RO-131
レイアウト設計ツール
Tanner(L-Edit)
機能及び仕様
半導体デバイス, 集積回路, MEMSデバイス設計用ソフト
機器利用料(円/時間)
3,300
設置場所
東棟

RO-132
MEMS設計ツール(IntelliSuite)
アドバンストテクノロジー
機能及び仕様
IntelliSuite
機器利用料(円/時間)
3,300
設置場所
東棟2F

