機器一覧
薄膜形成
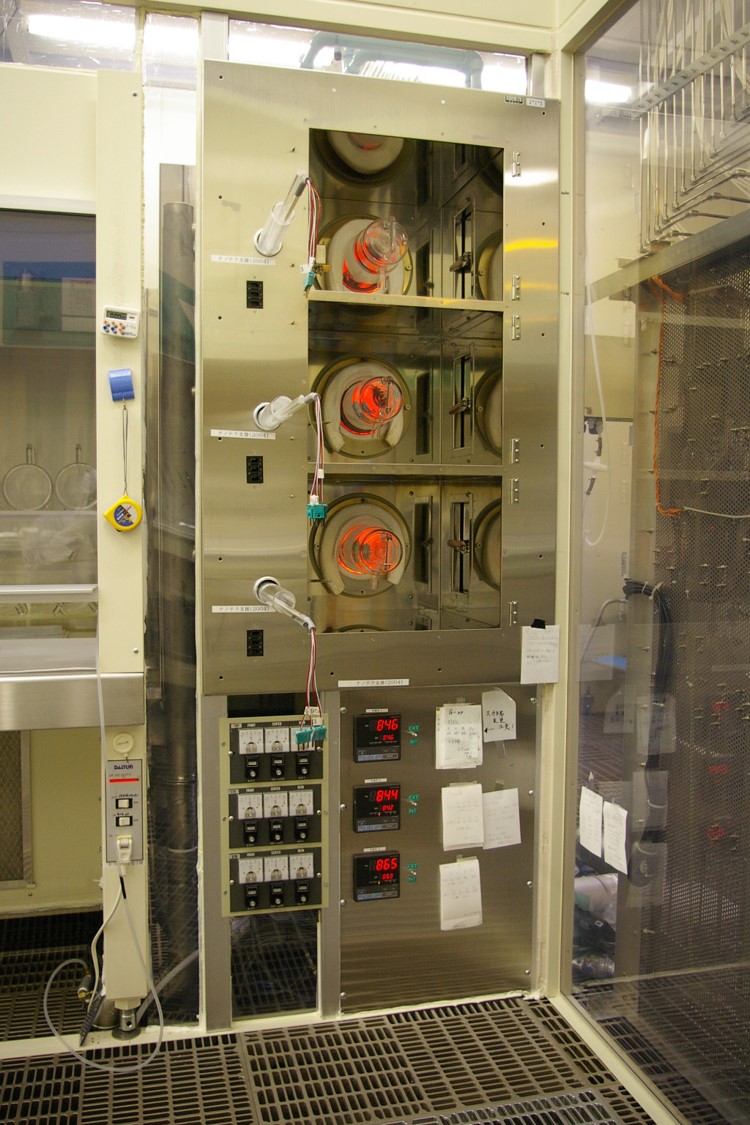
RO-221
酸化炉
CR
東京エレクトロン
機能及び仕様
Si基板上への熱酸化膜形成,最高使用温度1050℃
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
3,300
設置場所
CR西棟1F
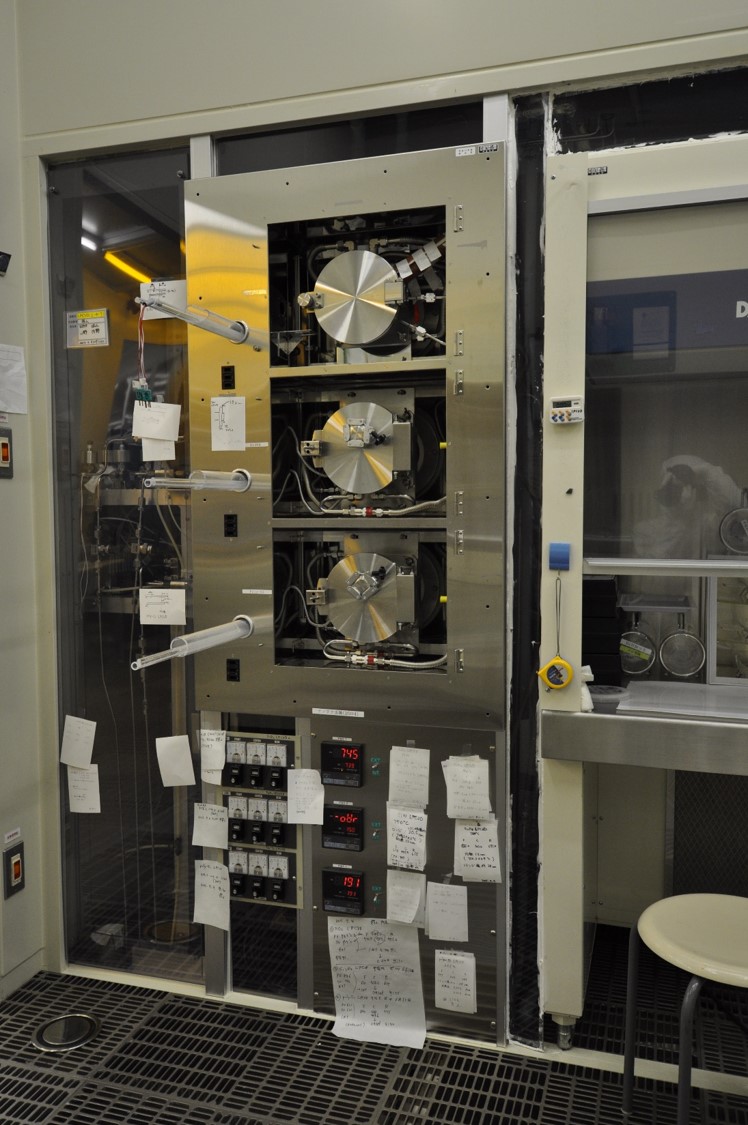
RO-311
LPCVD装置(Poly-Si用)
CR
東京エレクトロン
機能及び仕様
ポリシリコン成膜用,成膜温度635℃
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
6,600
設置場所
CR西棟1F
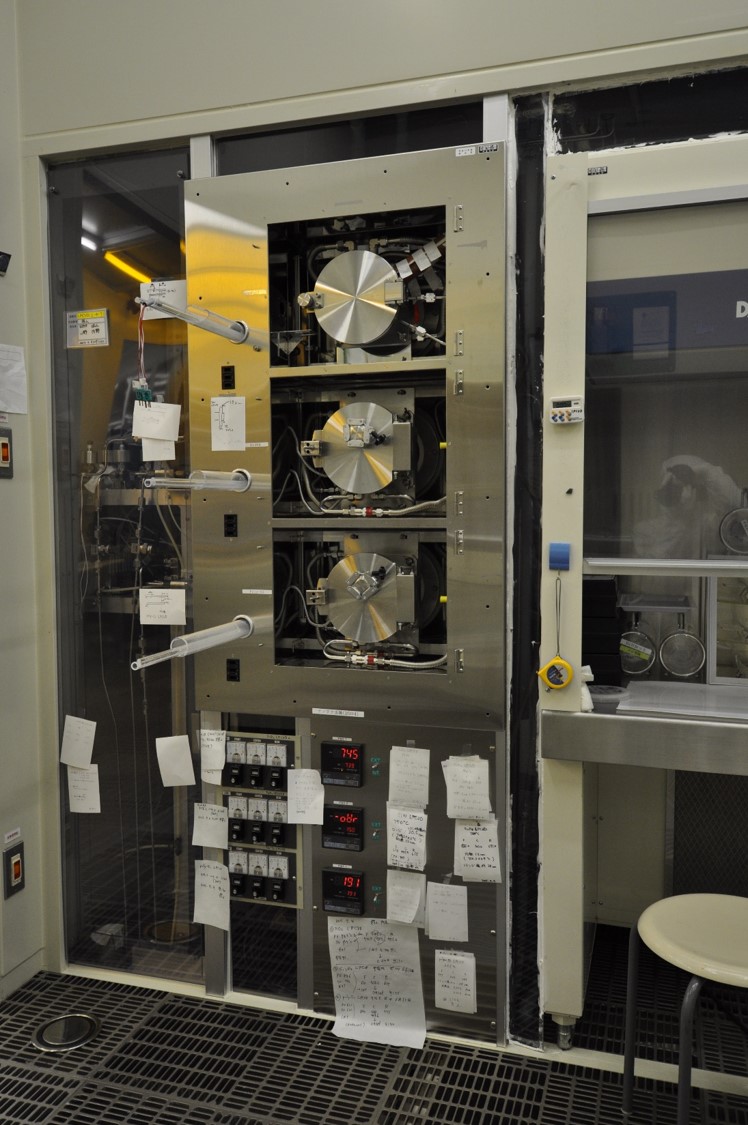
RO-312
LPCVD装置(SiN用)
CR
東京エレクトロン
機能及び仕様
窒化シリコン成膜用,成膜温度750℃
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
6,600
設置場所
CR西棟1F
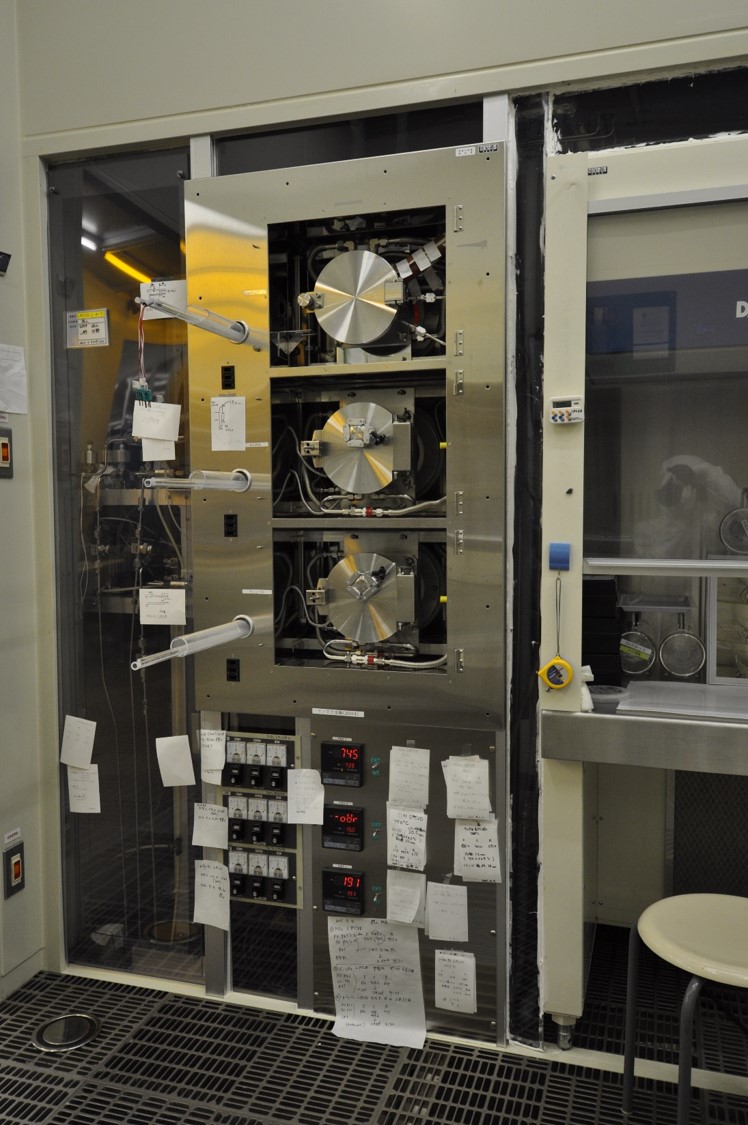
RO-313
LPCVD装置(SiO2用)
CR
東京エレクトロン
機能及び仕様
SiO2成膜用,モノシランと一酸化窒素混合モード、TEOS+オゾン の2つのモード可能,最高温度850℃
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
6,600
設置場所
CR西棟1F

RO-314
常圧SiO2CVD装置
CR
天谷製作所(M01)
機能及び仕様
SiO2成膜用,基板温度400℃,P(リン)のその場ドーピング可能
対応ウェハ
2 インチ
機器利用料(円/時間)
8,800
設置場所
CR西棟1F

RO-315
プラズマCVD(PECVD)装置
CR
アルバック(CPD-1108S)
機能及び仕様
SiO2,SiN薄膜の堆積
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
8,800
設置場所
CR西棟1F
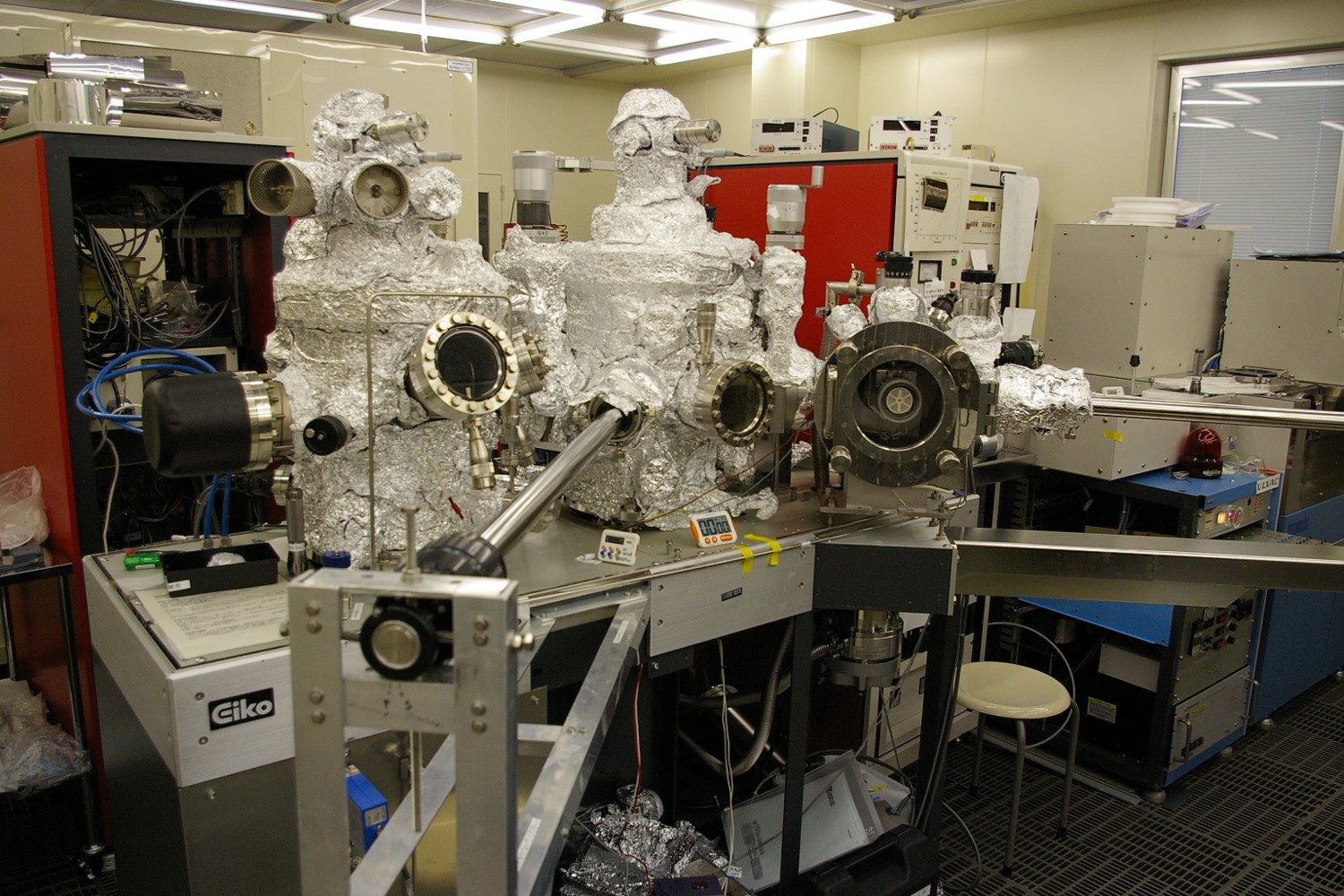
RO-321
スパッタ装置(Al用)
CR
エイコー
機能及び仕様
超高真空仕様,Al及びTi, TiNのスパッタが可能, DCマグネトロン(Ar, N2)
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
3,850
設置場所
CR西棟1F
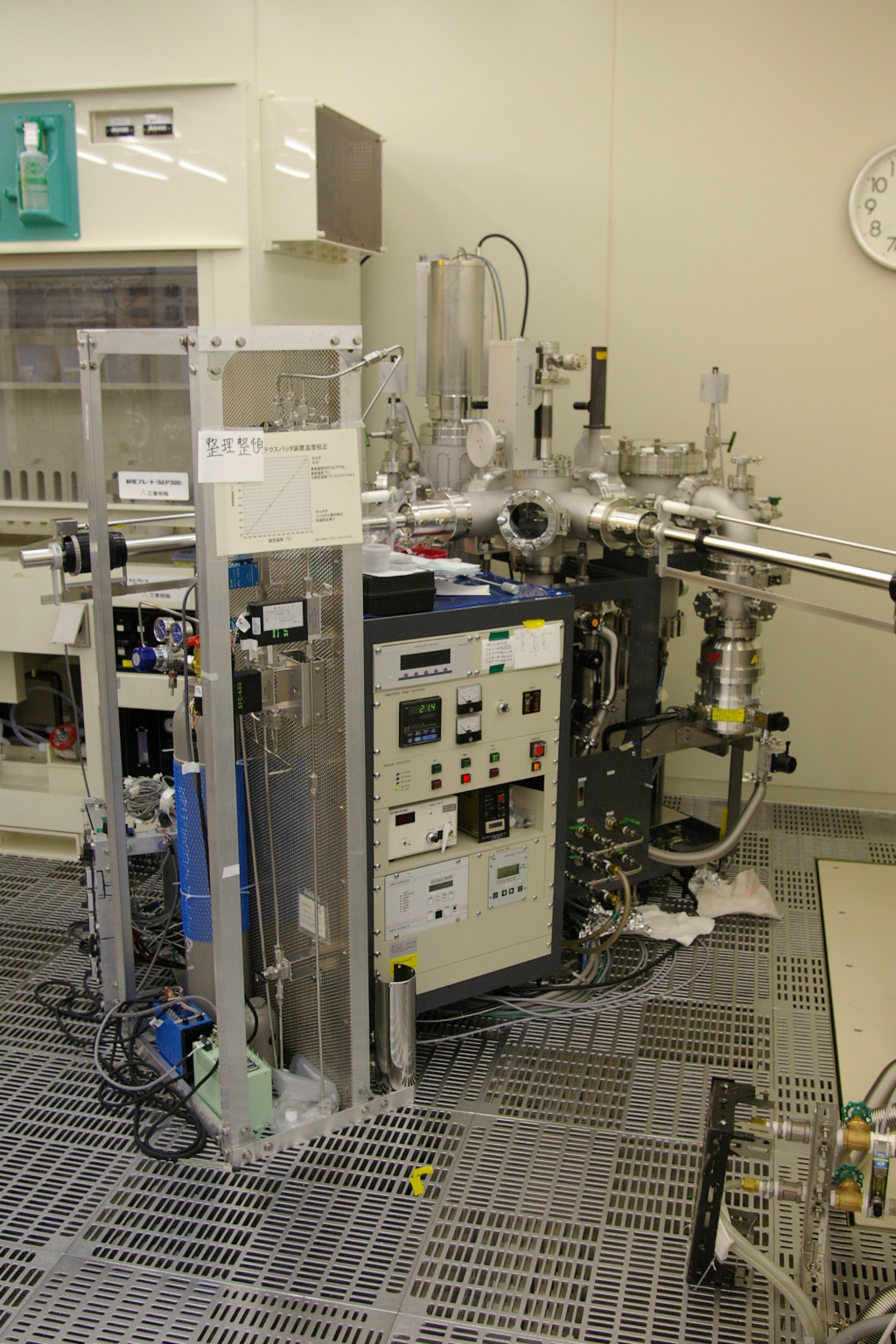
RO-322
スパッタ装置(汎用)
CR
エイコー
機能及び仕様
各種材料スパッタ用(3インチターゲット交換により広範な材料に対応)スパッタガス(Ar・O2・N2)
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
3,850
設置場所
CR東棟1F

RO-323
スパッタ装置(Cu用)
CR
機能及び仕様
Cu成膜用,DCマグネトロン(Ar, H2)
対応ウェハ
2 インチ
機器利用料(円/時間)
3,850
設置場所
CR東棟1F

RO-324
多元スパッタ装置
CR
キヤノンアネルバ(E-200S)
機能及び仕様
Ti, Ni, Nb, TiNのスパッタが可能(スパッタガス Ar・O2・N2)
対応ウェハ
2 インチ、カットウェハ
機器利用料(円/時間)
6,600
設置場所
CR東棟1F

RO-331
真空蒸着装置
CR
アルバック
機能及び仕様
抵抗加熱型の蒸着装置。2種類の材料をセットして多層膜を作成することも可能。Al、Au等。
対応ウェハ
2 インチ以下
機器利用料(円/時間)
2,200
設置場所
CR西棟地下

